| 항목 | CW1000 |
| 구조 |
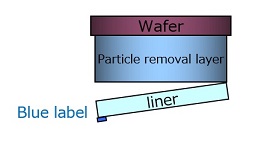
|
| 총 두께 | 720~900(μm) |
| 표면 경도 | 500Mpa(22°C) |
| 작동 온도 | -20~50℃ ※1 |
| 크기 | 6인치: 오리엔탈 플랫
8/12인치: V-노치 |
| 입자 유형 | Si, 금속(유기) |
| 입자 크기 | 0.2μm 이상(측정 값) |
※1 작동 온도가 50 °C보다 높은 경우 회사로 문의하시기 바랍니다. .
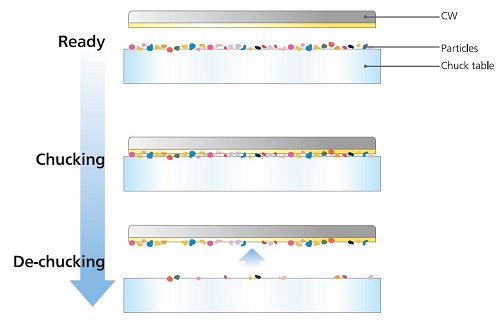
|
장비 | 효과 |
| 건식 에칭 | 냉각 헬륨 가스 안정화 | |
| 유지보수 시간 단축 | ||
| 프로버 | 정기 유지보수 빈도 감소 | |
| 리토그래피 | 진공 오류 감소 | |
| 초점 오류 감소 | ||
| 유지보수 시간 단축 | ||
| 이온 주입 | 정기 유지보수 빈도 감소 | |
| 장치 유형 | 대상 | |
| 메모리/로직 | 드라이 에쳐, 리소그래피, 스테퍼 | |
| 전원 장치 | 스테퍼, 프로버 | |
| Saw/Baw 필터 | 드라이 에쳐, 스패터링 | |
| MEMS | 드라이 에쳐 |
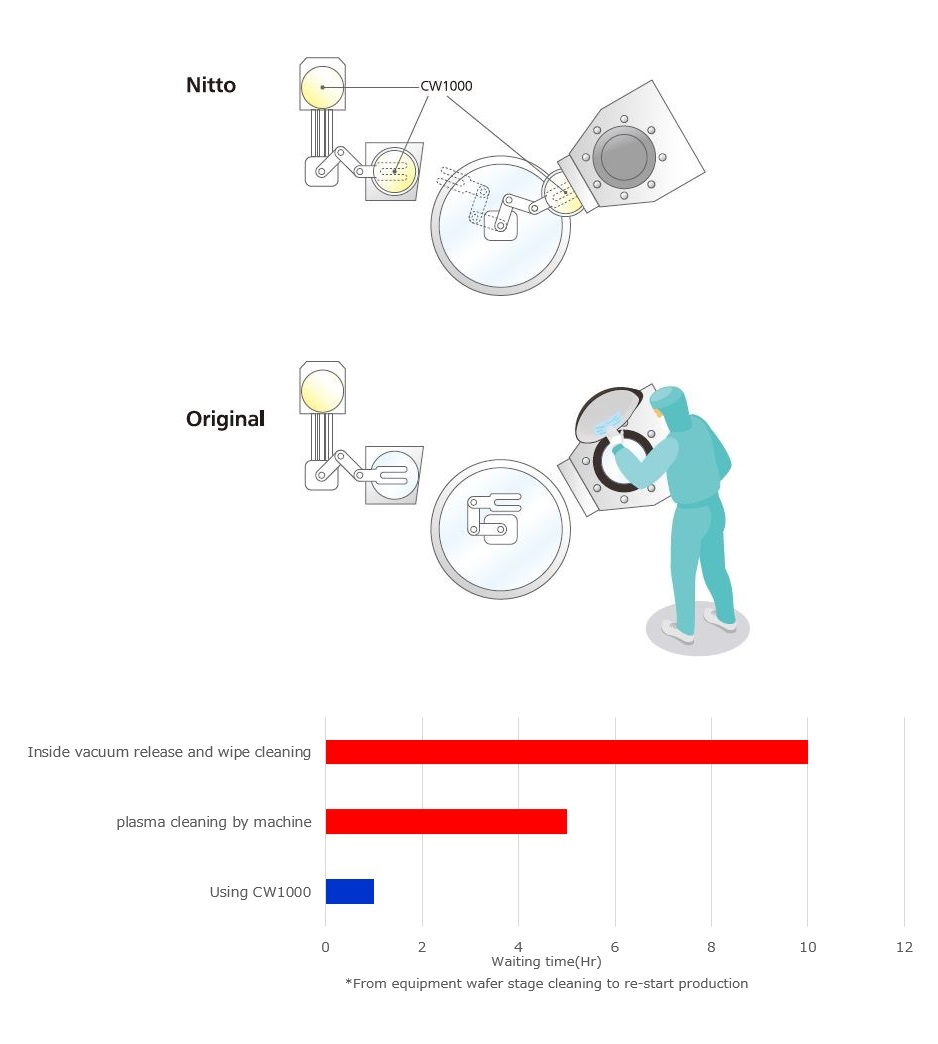 |
영업시간 (한국시간) 09:00-17:00(토∙일 공휴일 제외)