| 項目 | CW1000 |
| 構造 | 
|
| 製品厚み | 720~900 (μm) |
| 弾性率 | 500Mpa (22℃) |
| 適用温度 | -20~50℃ ※1 |
| サイズラインアップ | 6inch: JEITA オリフラ
8/12inch: Vノッチ |
| 対象異物 | Si, Metal (Organic) |
| 異物サイズ | 0.2μm以上 |
※1) 50℃以上の場合はお問い合わせください。
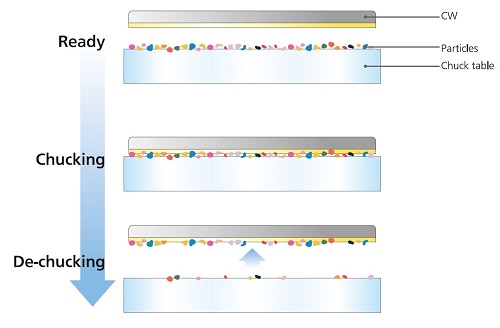 |
| プロセス | 効果 |
|---|---|
| ドライエッチング | 冷却ヘリウムの還流安定化 |
| メンテナンス時間最小化 | |
| プローブ | ウエハ薄化に伴う吸着時ウエハクラック・破損防止 |
| リソグラフィー | バキュームエラーの減少 |
| 焦点エラーの減少 | |
| メンテナンス時間最小化 | |
| イオン注入 | ステージ及び搬送アームのクリーニング |
| デバイス | 効果 |
|---|---|
| メモリ | ドライエッチャー、リソグラフィ工程 |
| パワーデバイス | 裏面プロセス形成、プローバー |
| Saw/Bawフィルタ | ドライエッチャー、スパッタ |
| MEMS | ドライエッチャー
詳細はMEMS製造課題の解決をご覧ください |
CW1000を用いることで、大気開放をする通常のチャンバー清掃よりダウンタイムを短くすることができます。
※大気開放清掃をするまでのスパンを伸ばすことができる。
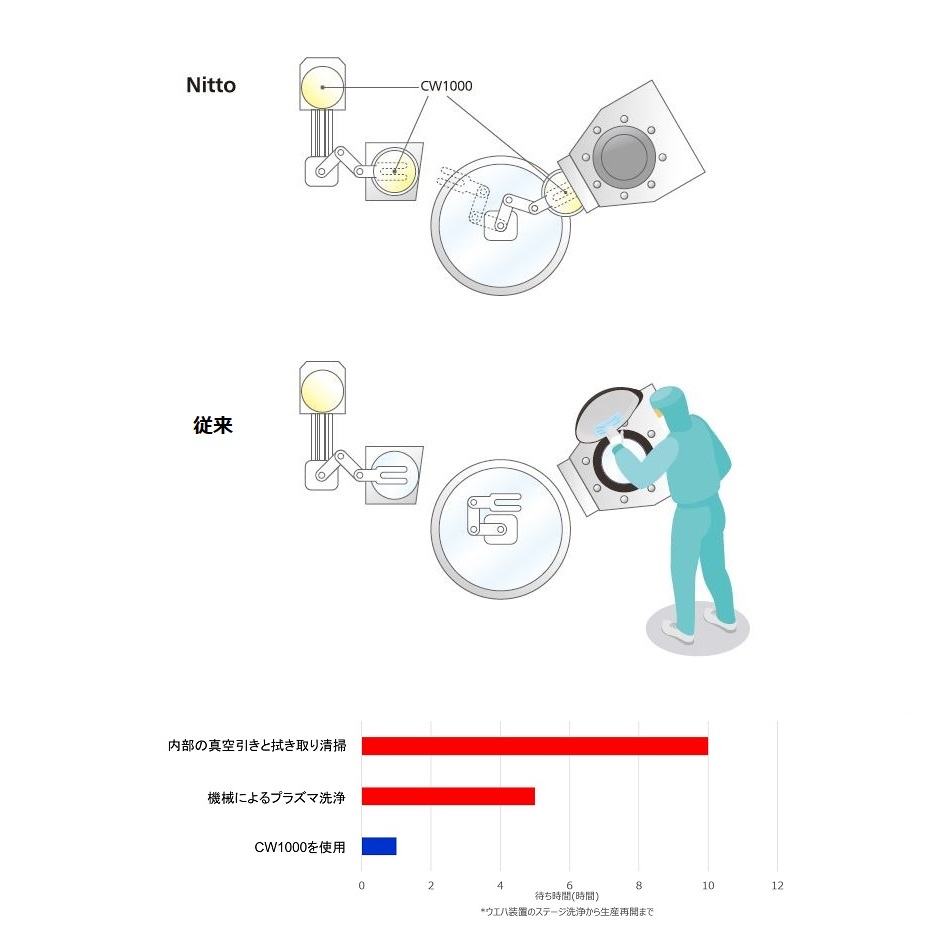 |